SE-1000 Spectroscopic Ellipsometry
This compact tabletop Spectroscopic Ellipsometer delivers precise thin film and optical property measurements in a modular, lab-friendly design. Covering a wide spectral range, it supports film thickness, refractive index, extinction ratio coefficient , and multilayer analysis with flexible measurement modes including ellipsometry, polarimetry, and twelve element Mueller-matrix.
関連出版物
A Novel Pretreatment for Thin-Film Measurements
Ammonia-vapour-induced two-layer transformation of mesoporous silica coatings on various substrates
Amphiphilic nanopores that condense undersaturatedwater vapor and exude water droplets
Analysis of malaria infection byproducts with Mueller matrix transmission ellipsometry
Benefit of Combining Metrology Techniques for Thin SiGe:B Layers
Beyond the Meso-/Macroporous boundary: Extending Capillary Condensation-based Pore Size Characterization in Thin Films Through Tailored Adsorptives
Block copolymer-assembled nanopore arrays enable ultrasensitive label-free DNA detection
Charging Behavior of Silicon Nitride Based Non-Volatile Memory Structures with Embedded Semiconductor Nanocrystals
Cleaning of Si Surfaces by Lamp Illumination
Detection of structural asymmetries in Forksheet FET arrays using Mueller matrix ellipsometry, a theoretical study
Ellipsometry Study of Process Deposition of Amorphous Indium Gallium Zinc Oxide Sputtered Thin Films
Ferroelectric HfO2 thin film testing and whole wafer mapping with non‐contact corona‐Kelvin metrology
Homogeneous Transparent Conductive ZnO:Ga by ALD for Large LED Wafers
Inkjet-Printed Vertically Emitting Solid-State Organic Lasers
Integrated Electrical and Optical Characterization of Large Area Thin Film Photovoltaic Materials
Internal wettability investigation of mesoporous silica materials by ellipsometric porosimetry
Monitoring subwavelength grating structures for vertical-cavity surface-emitting laser applications by spectroscopic ellipsometry
Near-infrared optical properties and proposed phase-change usefulness of transition metal disulfides
On Determining the Optical Properties and Layer Structure from Spectroscopic Ellipsometric Data using Automated Artifact Minimization Method
On the Rational Design of Mesoporous Silica Humidity Sensors
Spectroscopic Ellipsometry on Metal and Metal-Oxide Multilayer Hybrid Plasmonic Nanostructures
Spectroscopic ellipsometry investigation of free liquid-liquid and liquid-air interfaces
Structural Evolution of Silicon Nitride Anodes during Electrochemical Lithiation
Study of Annealing Effects Upon the Optical and Electrical Properties of SnO2:F/SiCxOy Low Emissivity Coatings by Spectroscopic Ellipsometry
The influence of stabiliser concentration on the formation of In2O3 thin films
関連ホワイトペーパー

August 18, 2025
Forksheet FET - the Future of Transistor Manufacturing?
Semilab, within the IT2 EU project, explores Mueller matrix ellipsometry as a powerful method to detect asymmetries in forksheet FETs—offering enhanced precision over conventional techniques and supporting Europe's push for semiconductor innovation.
August 18, 2025
How Does Advanced Metrology Benefit the PV Industry?
Explore how advanced metrology plays a crucial role in the photovoltaic industry by enhancing efficiency, ensuring quality control, supporting research and development, and reducing costs.
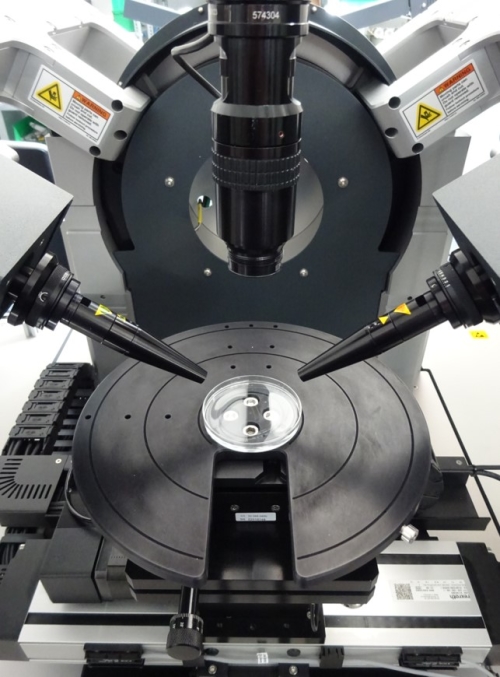
August 18, 2025
How Spectral Ellipsometry Measurements are Conducted on Bulk Liquids
Enabling precise optical characterization of bulk liquids using advanced spectral ellipsometry despite interface instability.

August 18, 2025
How to Determine the Internal Wettability of Nanostructured Thin Films
Advancing wettability analysis of nanostructured thin films with ellipsometric porosimetry and spectral ellipsometry.
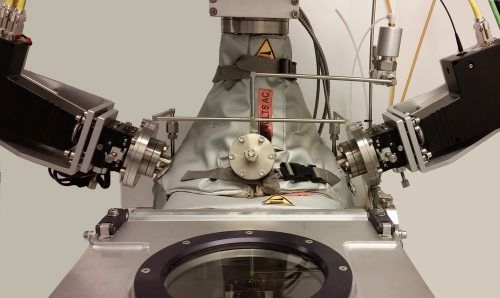
August 18, 2025
Precision Measurement Tools for the Sub-Nanoscale
Real-time in situ spectroscopic ellipsometry reveals key insights into sub-nanoscale growth of molybdenum carbide thin films.

October 17, 2025
R&D Keeps The World Moving Forward - So Are Semilab’s Spectroscopic Ellipsometry Solutions
Technological development is transforming every aspect of our lives and our world at an unprecedented rate, and Semilab proudly contributes to this incredible pace.

August 18, 2025
R&D Lab Tools for the Display Industry
Innovation in the electronic display industry is driven by advanced R&D tools enabling precise measurement and development.