Contact us for Information and Pricing
Get expert advice and tailored solutions for your research needs
Get expert advice and tailored solutions for your research needs
This high-performance, non-contact, non-destructive optical metrology tool provides precise measurement of thin film thickness and optical constants across single and multilayer structures. Designed for R&D labs, universities, and industries like semiconductor, PV and optics, it supports advanced modeling, mapping, and real-time data visualization.
Author
Lenke Kócs, Borbála Tegze, Emőke Albert, Csaba Major, András Szalai, Bálint Fodor, Péter Basa, György Sáfrán, Zoltán Hórvölgyi
Topic
porous silica coatings; spectroscopic ellipsometry; ELLIPSOMETRIC POROSIMETRY; mesoporous; anti-reflective coatings
Author
Baekmin Q. Kim1†, Zachariah Vicars1†, Máté Füredi2,3, Lilia F. Escobedo1, R. Bharath Venkatesh1‡, Stefan Guldin2,4,5, Amish J. Patel1*, Daeyeon Lee1
Topic
spectroscopic ellipsometry
Author
P. Basa, B. Fodor, Zs. Nagy, B. Oyunbolor, A. Hajtman, S. Bordács, I. Kézsmárki, A. Halbritter, Á. Orbán
Topic
ellipsometry; rotating compensator; mueller matrix; spectroscopic ellipsometer
Author
Máté Füredi, Cristina V. Manzano, András Marton, Bálint Fodor, Alberto Alvarez-Fernandez,*
Topic
EP
Author
Maximiliano Jesus Jara Fornerod, Alberto Alvarez-Fernandez, Máté Füredi, Anandapadmanabhan A Rajendran, Beatriz Prieto-Simón, Nicolas H. Voelcker, Stefan Guldin
Topic
spectroscopic ellipsometry
Author
Balogh Imre, Kiss Roberta Zsófia, Egri Dávid
Topic
spectroscopic ellipsometry
Author
Máté Füredi, Bálint Fodor, András Marton, Alberto Alvarez-Fernandez, Aysha ARiaz, Curran Kalha, Anna Regoutz, Stefan Guldin, Péter Basa
Topic
Ellipsometers; ellipsometry; ellipsometry porosimetry; ELLIPSOMETRIC POROSIMETRY; ELLIPSOMETRIC POROSIMETRY (R&D); Mesoporous silica films; Porosimetry; mesoporous
Author
Emeric Balogh, Peter Basa, Attila Suto, Benjamin Powell, Anna Bölcskei-Molnár, and Szilvia Biró
Topic
ellipsometry; spectroscopic ellipsometry
Author
Akshay Singh, Yifei Li, Balint Fodor, Laszlo Makai, Jian Zhou, Haowei Xu, Austin Akey, Ju Li and R. Jaramillo
Topic
ellipsometry; visible spectra; Transmission electron microscopy; Density functional theory; Photonic integrated circuits; Transition metal chalcogenides; Optical metrology; Crystalline solids; Optical electronics
Author
Máté Füredi, Alberto Alvarez-Fernandez, Maximiliano Jesus Jara Fornerod, Bálint Fodor, and Stefan Guldin
Topic
spectroscopic ellipsometry; EP
Author
László Makai, Benjamin Kalas, György Tiborcz
Topic
Ellipsometers; ellipsometry; Interfaces; spectroscopic ellipsometry; Surface; Surface measurement
Author
Adam J. Lovett*, Máté Füredi, Liam Bird, Samia Said, Brandon Frost, Paul R. Shearing, Stefan Guldin, Thomas S. Miller*
Topic
spectroscopic ellipsometry
Author
Aysha A. Riaz, Curran Kalha Maria Basso, Máté Füredi, Anna Regoutz
Topic
spectroscopic ellipsometry

August 18, 2025
Semilab, within the IT2 EU project, explores Mueller matrix ellipsometry as a powerful method to detect asymmetries in forksheet FETs—offering enhanced precision over conventional techniques and supporting Europe's push for semiconductor innovation.
August 18, 2025
Explore how advanced metrology plays a crucial role in the photovoltaic industry by enhancing efficiency, ensuring quality control, supporting research and development, and reducing costs.
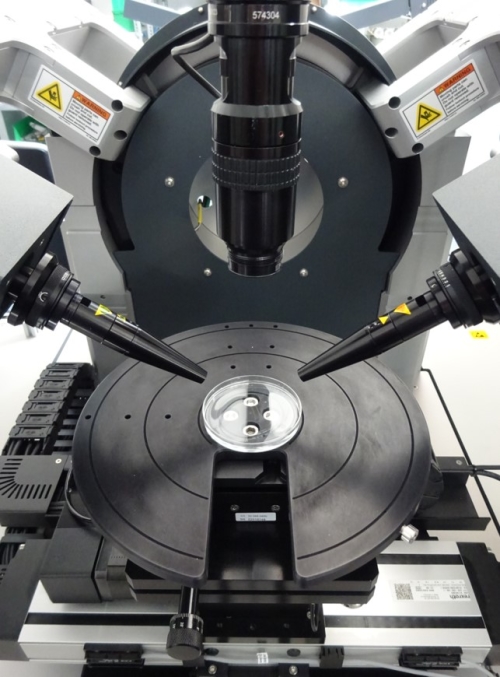
August 18, 2025
Enabling precise optical characterization of bulk liquids using advanced spectral ellipsometry despite interface instability.

August 18, 2025
Advancing wettability analysis of nanostructured thin films with ellipsometric porosimetry and spectral ellipsometry.
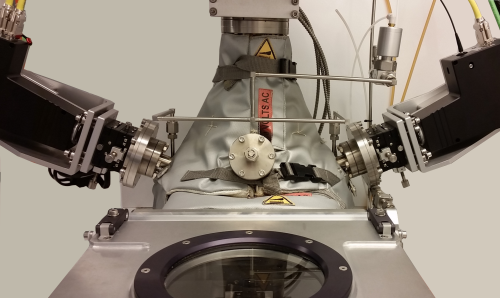
August 18, 2025
Real-time in situ spectroscopic ellipsometry reveals key insights into sub-nanoscale growth of molybdenum carbide thin films.

October 17, 2025
Technological development is transforming every aspect of our lives and our world at an unprecedented rate, and Semilab proudly contributes to this incredible pace.

August 18, 2025
Innovation in the electronic display industry is driven by advanced R&D tools enabling precise measurement and development.